- 功率MOSFET基础
-
内容表
10.雪崩能力和额定
11.dV/dt额定
12.热阻特性
13.功率耗散
14.安全工作区
15.电流额定
1.基本器件结构
功率MOSFET (金属氧化物半导体场效应晶体管)是非常通用的功率器件,因为它具有低的栅极驱动功率,快的开关速度和优异的并联工作能力。许多功率MOSFET具有纵向的垂直结构,源极和漏极在晶元的相对的平面,从而可以流过大的电流和具有高的电压。
图1a和1b示出沟漕和平面两种基本的器件结构。沟漕结构主要用于额定电压低于200V的器件,因为它具有高的沟道密度,因此导通电阻低。平面结构适合于更高的额定电压器件,因为导通电阻主要由epi-层的电阻来决定,因此无法得到高的单元密度。两种结构基本的操作相同。除了特别的定义,本文只讨论沟漕结构。
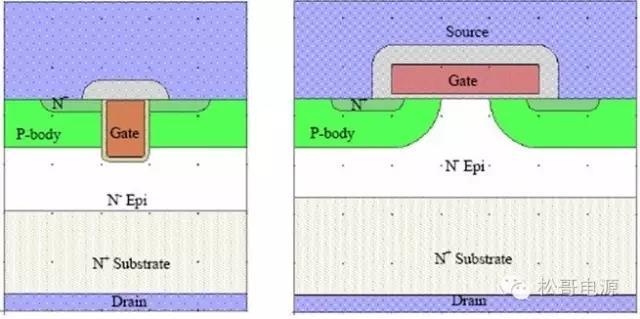
Figure 1a: 沟漕MOSFET结构 Figure 1b: 平面MOSFET结构
2.击穿电压
在许多功率MOSFET中,N+ 源极和P-体形成的结是通过金属物短路的,从而避免意外的导通寄生的三极管。当没有偏置加在栅极时,功率MOSFET通过反向偏置P-体和N- Epi形成的结,可以承受高的漏极电压。
在高压器件中,绝大部分电压由少掺杂的Epi层来承受:厚的少掺杂的Epi层承受更高的击穿耐压,但是增加了导通电阻。在低压器件中,P-体掺杂程度和N- Epi层差不多,也可以承受电压。如果P-体的厚度不够,重掺杂太多,耗尽区可以通孔达到N+ 源极区,从而降低了击穿电压值。如果P-体的厚度太大,重掺杂不够,沟道的电阻和阈值电压将增大。因此需要仔细的设计体和Epi掺杂和厚度以优化其性能。
数据表中,BVDSS通常定义为漏电流为250uA时漏极到源极的电压。漏极到源极的漏电流表示为IDSS,它在100%的BVDSS额定时测量。温度增加,IDSS增加,BVDSS也增加。
3.导通状态特性
要考虑功率MOSFET在两种不同的模式下工作:第一象限和第三象限工作。
第一象限工作
当正向电压加在漏极上时,N沟道的功率MOSFET操作在第一象限工作,如图2所示。当栅极电压VG增加到阈值电压VTH时,MOSFET沟道开始流过电流。它流过电流的值取决于MOSFET的导通电阻,定义为:
RDSON=VD/ID
对于足够的栅极电荷过驱动VG>>VTH,ID-VD曲线操作在线性区,因为MOSFET的沟道完全导通。在低的栅极过驱动电压下,当VD>(VG-VTH),由于沟道的修剪效应,漏极电流达到饱和点。
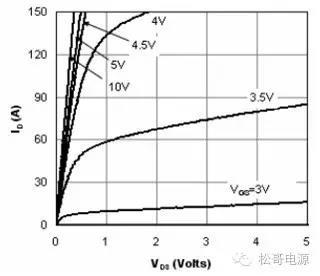
图2: 导通区特性(第一象限)
对于沟漕MOSFET, RDSON由于下面几个部分组成:
- RS: 源极电阻
- RCH: 沟道电阻
- RACC: 聚集区电阻
- REPI: 硅片顶层电阻,外延硅,有名epi;epi控制着MOSFET可以承受阻断电压值
- RSUBS: 硅衬底电阻,epi从它上面生长。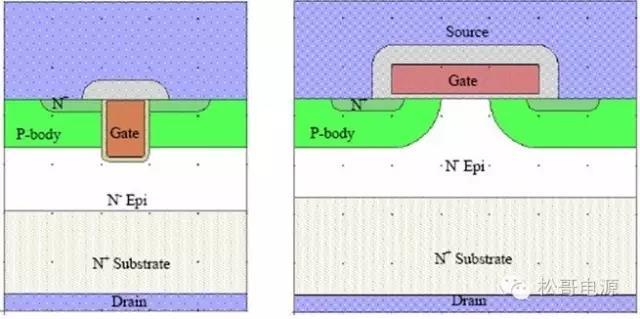
图3a: 沟漕RDSON组成 图3b: 平面MOSFETRDSON组成
对于平面MOSFET, RDSON组成部分和沟漕MOSFET相似。主要的不同在于出现JFET部分。当器件缩小到更小的尺寸,RS, RCH, RACC也减小,因为更多的单个的单元晶胞将堆积在给定的硅片区。另一方面,当电流被限制在靠近P-体区的狭窄的n-区流过时,RJFET将遭受JFET效应。由于没有JFET效应,沟漕MOSFET可以得到更高密度的缩减,实现低的RDSON。
沟道电阻RCH主要依赖于栅极过驱动程度。VGS增加,RCH减小。开始时,当VGS增到VTH以上时,RDSON很快降减小,表明MOSFET沟道导通。当VGS进一步增加,RDSON下降比较来缓,因为沟道完全导通,MOSFET导通电阻由其它的电阻组成部分决定。RDSON随温度增加而增加,因为温度增加,载流子运动能力降低,这是器件并联工作的重要特性。
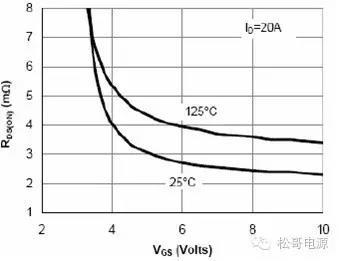
图4: RDSON对栅极偏置和温度
阈值电压
阈值电压VGS(TH)定义为最小的栅极偏置电压,此时,在源极和漏极间形成导通的沟道。对于功率MOSFET,通道在250uA的漏源极电流时测量。栅极氧化层厚度和沟道掺杂集中度用来控制阈值电压。10-15V的驱动电压,其典型值设计为2-4V。使用CMOS技术缩减,功率MOSFET的栅极驱动电压可以降到的2.5-4.5V。因此,这些应用需要更低的阈值电压1-2V。阈值电压具有负的温度系数,温度增加,阈值电压降低。
跨导
跨导gfs,定义为MOSFET的增益,可以用下面公式表示:
gfs=DIDS/DVGS =μCox W/LCH
通常在固定的VDS,在饱和区测量。器件栅极宽度W,沟道长度LCH,活动性μ,栅极电容COX,影响跨导值。温度增加,跨导降低,因为载流子的活性降低。
第三象限工作
在DCDC的BUCK变换器中,功率MOSFET在第三象限工作很常见,电流流过下面N沟道的MOSFET,和第一象限比较,电流方向是反向的,施加的RDSON相同。
在相对低的电流时,第三象限工作的导通特性和第一象限是对称的。因此可以假定两种操作典型有相同的RDSON。在大的电流和大的VDS时,它们工作方式不同。当VDS接近体二极管的正向压降时,体二极管开始导通。因此,电流增加,不能看到电流饱和特性。

图5: 第三象限工作
4.电容
MOSFET的开关特性受器件三个管脚的寄生电容的影响,也就是栅极源极电容CGS,栅极漏极电容CGD和漏极源极电容CDS,如图6所示。这些电容值是非线性的,和器件结构,几何特性和偏置电压相关。
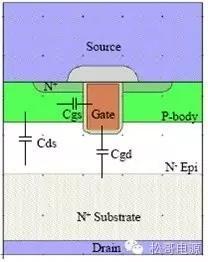
图6: MOSFET寄生电容
开通时,电容CGD和CGS 通过栅极充电,因此设计栅极的控制电路时必须考虑电容的变化。MOSFET的数据表提供的寄生电容参数,CISS,COSS,和CRSS。
CGD = CRSS
CGS = CISS − CRSS
CDS = COSS − CRSS
CRSS = 小信号反向传输电容。
CISS =小信号输入电容,漏极和源极短路。
COSS =小信号输出电容,栅极和源极短路。
MOSFET的电容是非线性的,是直流偏置电压的函数。图7示出了电容如何随VDS电压增加而变化。所有的MOSFET的寄生电容来源于不依赖于偏置的氧化物电容和依赖于偏置的硅耗尽层电容的组合。当电压增加时,和VDS相关电容的减小来源于耗尽层电容减小,耗尽层区域扩大。
图7b示出了当VGS电压增加大于阈值电压,VDS电压值低,MOSFET栅极电容也增加,因为MOS沟道电子反形层形成,在沟漕底部形成电子聚集层。这也是为什么一旦电压超过QGD阶级,栅极电荷特性曲线的斜率增加的原因。
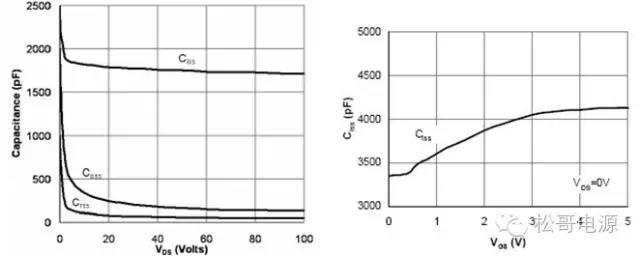
图7a: 典型电容随VDS变化 图7b: 典型输入电容 Ciss随 VGS变化
5.栅极电荷
如果知道了栅极的驱动电流,栅极电荷参数可以用来估算功率MOSFET开关时间。这只取决于器件的寄生电容。这个参数受漏极电流,电源电压和温度的影响较小。栅极电荷测试的原理图和相关波形见图8所示。在此电路中,恒定的栅极电流源Ig给测试器件的栅极充电,漏极电流ID由外部提供。测量VGS和栅极充电时间,可以直接表明漏极电流从0增加到ID,同时,漏极电压从VDC减小完全导通电压时,器件所消耗的能量。
在栅极电流开通前,测试的器件承受的所有电源电压VDC,而VGS电压和漏极电流为0。一旦栅极电流Ig开始流过,栅极源极电容CGS和栅极漏极电容CGD开始充电,栅极到源极电压开始增加。充电的速度为IG/CISS。当VGS电压达到阈值电压后,漏极电流开始流过。栅极电压开始上升到平台电压VGP (VGSTH+ID/gFS),而测试器件的电压保持在电源电压VDC需要达到这种状态的电荷Ig*time为QGS。当漏极的电流到达ID时,漏极的电压开始下降,此时,VGS保持在恒定的VGP值。栅极电流用来给电容CGD充电,Ig= CGD dVDS/dt。当VDS接近导通状态时,平台阶段结束。在平台阶段,注入的栅极电荷为QGD,通常用它来估算电压转换的时间和开关损耗。
下一步,测试器件的栅极继续充电到最终的值,漏源极电压变为RDSON x ID。栅源极电压自由的上升,上升的斜率由栅极的充电电流和CISS决定,在VGS>VTH时,CISS更高,图7b所示,导致在栅极电荷曲线上,更低的斜率,直到栅源极电压达到最大值。这个栅极的电荷是所有栅极电荷QG。


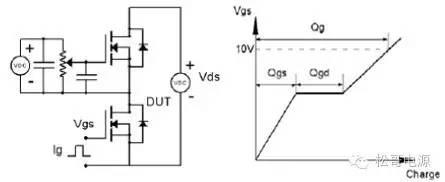
图8: 栅极电荷测试电路和波形
6.栅极电阻
对于栅极的驱动,功率MOSFET栅极呈现和RC网络类似的阻抗。等效的电阻就是指栅极的电阻Rg。栅极的电阻由栅极多晶硅导体,金属和连接结构的电阻产生。连接结构就是为了连接外部封装的管脚,所布设的到焊盘的栅极信号线。
对于多晶硅栅极功率沟漕MOSFET,栅极的电阻取决于掺杂的程度和多晶硅材料的类型(N或P型),栅极沟漕的几何特性和器件设计的安排。对于同样器件设计,N型沟漕功率MOSFET通常比P型有更低栅极电阻,因为在合适掺杂的多晶硅中,N型具有更低的薄膜电阻。许多开关器件最后要使用LCR仪,100%的测量Rg。
7.开通和关断
功率MOSFET数据表通常有阻性负载的开关特性,取决于Rg,Ciss和Crss。当寄生的电感和栅极驱动细节因素影响到实际的测量时,可以检查基本的物理特性。图9示出了功率MOSFET阻性负载开关测试电路和波形。
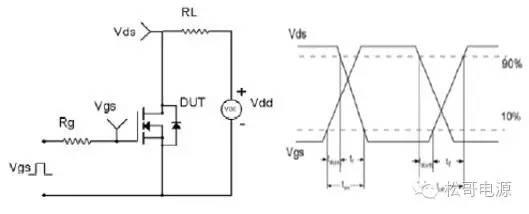
图9:阻性负载开关测试电路和波形
td(on) – 开通延时时间,这个值是Vgs上升到超过10%的栅极驱动电压,同时漏极电流上升到超过规定值的时间,在td(on)时刻,VGS达到阈值电压,这段时间由Rg Ciss时间常数数千决定。
tr – 上升时间,这个值是漏极电流从10%负载电流上升到90%的负载电流时间,取决于VTH,跨导gFS和Rg Crss时间常数。
td(off) –关断延时时间,这个值是Vgs下降到90%的栅极驱动电压,同时漏极电流下降到低于90%负载电流的时间,是电流开始转移到负载中的延时,取决于Rg Ciss。
tf – 下降时间,这个值是漏极电流从90%负载电流下降到10%的负载电流时间,取决于VTH,跨导gFS和Rg Crss时间常数。
8.体二极管正向压降
VSD是集成的体内二极管在施加一定的源极电流时,正向压降的测量值。施加的源极电流典型值为1A,在数据表中,它和正向压降的最大限制值一同定义。图10示出了二极管在两种温度下的典型的正向I-V特性。对于AOS SRFET,典型的VSD比通常的MOSFET要低,为0.4V。低的VSD可以减小二极管导通时的功率损耗。因此,SRFET是DCDC变换器下管FET,以及其它要求体二极管导通一定时间的应用的理想选择。
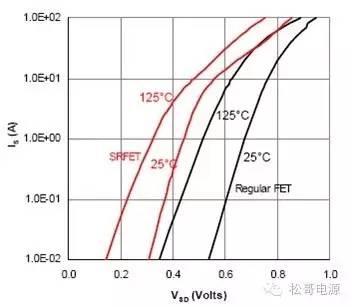
图10:体二极管正向特性
9.体二极管反向恢复
当二极管从导通状态切换为关断状态时,MOSFET的寄生体二极管产生反向恢复,因为存储的少子电荷必须被清除,在器件内部,或者通过负电流主动的清除,或者通过复合被动的清除。
在数据表中,有三个参数列出来表示二极管的反向恢复。
trr: 体二极管反向恢复时间。
IRM: 体二极管反向峰值电流。
Qrr: 体二极管反向恢复电荷,就是二极管电流波形的负电流部分的面积。
上面的参数随着测试条件的变化而变化,如加的电压VDS和di/dt等。参数的定义和测试的电路如图11所示。
&nb
中文 | English | tiếng Việt
